常见的元器件返修
在PCBA加工中,常用的电子元器件的返修主要有3种:Chip元件的返修、多引脚器件的返修和BGA的返修。
(1)Chip元件的返修
片状电阻、电容、电感通常被称为Chip元件,Chip元件的返修较为简单,既可以使用普通电烙铁,也可以使用简易型返修设备进行返修,但是Chip元件较小,在对其加热时,温度要控制得当,一般停留在焊盘上的时间不得超过3s,否则过高的温度将会使元件受热损坏。
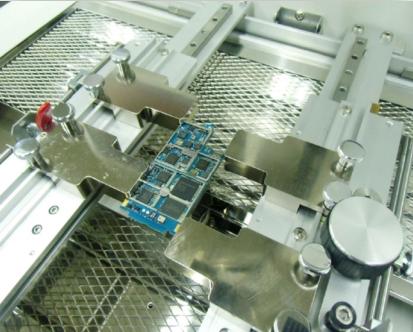
(2)多引脚器件的返修
对于PLCC、LCCC和QFP等多引脚器件的返修,维修者要有过硬的拆焊技能,拆除电路板上的器件要保证电路板的完好性,尤其是焊盘极易因过热或焊锡没有全部融化而被破坏。如何更好地拆焊也有一些小技巧,比如对于认为损坏的器件完全可以先剪断所有的管脚,然后拆除单独的管脚就容易多了;对于与大面积覆铜面相连的管脚一定要用大功率烙铁去熔化焊锡,这样可以在热量没有传导出去,对周边器件没有影响之前完成任务。
拆除焊接器件时,吸锡器与烙铁的配合是非常重要的,时机上要待到焊锡熔融状态时将其吸出,烙铁同时要将管脚推向焊孔中心,让焊锡被吸干净,一定要记住,用烙铁的热量而不是手的力量,如果留有残余的焊锡,可以用细铜网将其吸出,沾有助焊剂的铜网吸锡性非常好。焊接要避免虚焊和短路,正确的焊接原则是用尽量少的焊锡充满焊孔,并在管脚处形成一个光洁的锥体。
(3)BGA的返修
BGA返修台分光学对位与非光学对位,光学对位通过光学模块采用裂棱镜成像;非光学对位则是通过肉眼将BGA根据PCB板丝印线及点对位,以达到对位返修。BGA的返修工艺流程主要有拆卸BGA、清洁焊盘、去潮处理、印刷焊膏、贴装BGA和焊接检验等。

其中,拆卸BGA是将热风喷嘴扣在器件上进行加热至一定温度,然后选择适合拆卸器件的吸嘴,调节吸取器件的真空气压以及吸嘴高度,将BGA芯片拆卸下来,要注意器件四周的距离均匀,如果器件周围有影响热风喷嘴操作的元件,应先将这些元件拆卸,待返修完毕再焊上将其复位;清洁焊盘是用烙铁将PCB焊盘残留的焊锡清理干净、平整,可采用拆焊编织带和扁铲形烙铁头进行清理,操作时注意不要损坏焊盘和阻焊膜;去潮处理是指贴装前检查开封器件的湿度显示卡,当指示湿度>20%,说明器件已经受潮,应把器件放在耐高温的防静电塑料托盘中进行烘烤;印刷焊膏必须采用和BGA芯片对应的小模板,模板厚度与开口尺寸要根据球径和球距确定,一般我们采用植球工艺;贴装BGA是选择适当的吸嘴,打开真空泵,将BGA器件吸起来,用摄像机顶部光源照PCB上印好焊膏的BGA焊盘,调节焦距使监视器显示的图像最清晰,然后拉出BGA专用的反射光源,照BGA器件底部并使图像最清晰,然后调整工作台的旋钮,使BGA器件底部图像与PCB焊盘图像完全重合后将吸嘴向下移动,把BGA器件贴装到PCB上,然后关闭真空泵;焊接和检验和返修其它SMD器件差不多。


