SMC/SMD的发展趋势
表面组装元器件发展至今,已有多种类型封装的SMC/SMD 用于电子产品的生产,如图1-1-4 所示。IC 引脚间距由最初的1.27mm 发展至0.8mm,0.65mm,0.4mm 和0.3mm,SMD器件由SOP(Small Outline Package,小外形封装)发展到BGA(Ball Grid Array,球栅阵列封装)、CSP(Chip Scale Package,芯片级封装)以及FC(Flip Chip,倒装焊裸芯片),其指导思想仍是I/O 越来越多,可靠性越来越好。
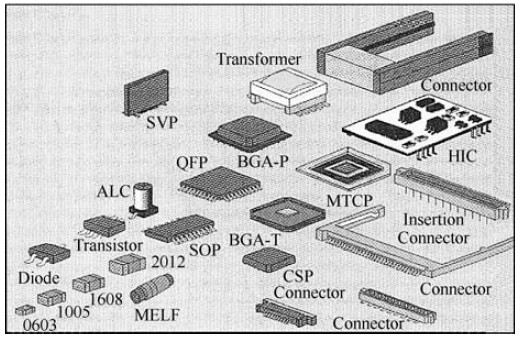
多种多样的SMC/SMD封装
新型器件的出现必然带来众多的优越性,如CSP 不仅是一种芯片级的封装尺寸,而且是可确认的优质芯片,具有体积小、质量轻、超薄(仅次于FC)等优点,但也存在一些问题,特别是能否适应大批量生产。一种新型封装结构的器件,尽管有无限的优越性,但如果不能解决工业化生产的问题,就不能称为好的封装。CSP 就是因其制作工艺复杂,即制作中需要用微孔基板,否则难以实现芯片与组件板的互连,从而制约了它的发展。新型的IC 封装的趋势是尺寸必然更小、I/O 更多、电气性能更高、焊点更可靠、散热能力更强,并能实现大批量生产。
1、MCM(Multi Chip Module,多芯片组件)级的模块化芯片
目前,MCM 是以多芯片组件形式出现的,一旦它的功能具有通用性,组件功能就会演化成器件的功能,它不仅具有强大的功能,而且具有互换性,并能实现大批量生产。
2、芯片电阻网络化
目前已经面世的电阻网络由于标准化和设计限制,尚未能广泛推广,若在芯片上集成无源组件,再随芯片一起封装,将会使器件的功能更强大。
3、SIP(System in Package,系统级封装)
SIP 称为系统级封装或封装内系统,是多芯片封装进一步发展的产物。SIP 中可封装不同类型的芯片,芯片之间可进行信号存取和交流,从而实现一个系统所具备的功能。
4、SoC(System on Chip,系统级芯片)
SoC 称为芯片上系统,又称为系统级芯片,它的意义就是在单一芯片上具备一个完整的系统运作所需的IC,这些主要IC 包括处理器,输入/输出装置,将各功能组快速连接起来的逻辑线路、模拟线路,以及该系统运作所需要的内存。这种将系统级的功能模块集成在一块芯片上使集成度更高,器件的引出端数为300~400,是典型的硅圆片级封装。
5、SOl(Silicon On lnsulator,硅绝缘)技术
对硅芯片技术的深入研究,使得SOI 技术得以崭露头角,SOI 技术能与硅集成工艺完全相容,完全继承了硅材料与硅集成电路的成果,并有自己独特的优势。
CMOS(Complementary Metal Oxide Semiconductor,互补型金属氧化物半导体)是超大规模集成电路发展的主流,硅绝缘CMOS 是全介质隔离的,无闩锁效应,有源区面积小,寄生电容小,漏电流小,在集成电路的各个领域有广泛应用。SOI 技术的成功为三维集成电路提供了实现的可能性,也为进一步提高集成电路的集成度和速度开辟了一个新的发展方向。因此,SOI 技术的出现必将会给现有的IC 封装形式带来新的挑战。
6、纳米电子器件
纳米技术的研究为微电子技术开创了新的前途和应用领域。美国从1982 年就开始研究量子耦合器件,德国、法国、日本等国家也都在近年加大对纳米技术的投入。美国TI 公司是最早开始研究纳米器件的公司,包括量子耦合器件、模拟谐振隧道器件、量子点谐振隧道二极管、谐振隧道晶体管、纳米传感器、微型执行器以及与这两者有关的MEMS 系统。美国IBM公司与日本日立制作所中央研究所都已研制成功单电子晶体管、量子波器件。

表面组装元器件的发展随着芯片内容的增多,I/O 端子数也增多,必将带来芯片封装形式的改进,在新材料、新技术不断涌现的情况下,必将会出现性能更优、组装密度更高的新的封装形式。


