回流焊主要缺陷分析
在SMT的回流焊工艺中,经常会有一些缺陷问题,实际回流焊常见缺陷主要有6种:焊球、虚焊、空洞、桥接、立碑、移位。这些回流焊缺陷主要受模板、焊膏、以及回流焊工艺参数等因素影响。
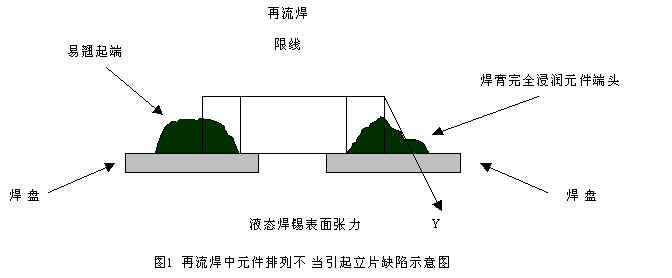
回流焊主要缺陷分析:
(1)焊球:焊球又称为锡珠,是焊接时粘附在印制板、导体上的焊料小圆球,主要是由预热温度上升过快,模板设计结构不当,贴片至回流焊的时间太长等因素造成的。其中,预热温度上升过快,使焊膏内部的水分、溶剂未完全挥发出来,到达回流区时就会引起水分、溶剂沸腾,溅出焊球;贴片至回流焊的时间太长,焊膏容易被氧化,焊剂变质,活性降低,会导致不回流而形成焊球。
(2)虚焊:虚焊是焊接后,焊端与焊盘之间或引脚与焊盘之间有时出现的电隔离现象,主要是由焊盘或元器件可焊性差;印刷参数不正确;回流焊温度和升温速度不当等因素引起的。其中,印刷参数不正确,主要是焊膏的问题,应当减小焊膏黏度,检查刮刀压力及速度;回流焊温度和升温速度不当,要重新调整回流焊温度曲线。
(3)空洞:焊点中出现孔径不一的空洞,大者称为吹孔,小者称为针孔,主要是由于焊膏黏度太小;助焊剂不合适;预热温度过低等印刷造成的。其中,助焊剂不合适,可能是助焊剂中的活性剂、有机溶剂及高沸点有机物与温度曲线设定不匹配,应选择合适的助焊剂,设置合适的温度曲线;预热温度过低,将导致焊膏中的水分和溶剂未及时逸出,被快速氧化后形成空洞,应增加预热时间,提高预热温度,赶走过多的水分和溶剂。
(4)桥接:两个或两个以上不相连的焊点的焊料相连在一起,桥接又称桥连,主要是由于焊膏黏度太低,触变性差;焊膏太多;加热速度过快等印刷造成的。其中,焊膏黏度太低,容易造成焊膏坍塌,应增加焊膏中金属含量或黏度;焊膏太多,应减小模板网孔的大小,降低刮刀压力。
(5)立碑:立碑是指无引脚元器件的一端被提起,且站立在它的另一端上,主要是由于贴装位置偏移;焊盘设计不合理;加热速度过快且不均匀等印刷造成的。其中,贴装位置偏移,将导致元器件两端焊膏不一样多,焊接时容易造成立碑,应调整贴装参数,选择合适的高度;加热速度过快且不均匀,将导致元器件两端焊膏不能同时熔化,从而使两端的表面张力不平衡,容易产生立碑,应重新调整回流焊温度曲线。
(6)移位:移位是焊点在平面内横向、纵向或旋转方向偏离预定位置,主要是由于焊膏印不准、厚度不均;传热不均,引脚可焊性不好;焊膏中焊剂含量太高等印刷造成的。其中,焊膏印不准、厚度不均,应重新调整印刷参数;焊膏中焊剂含量太高,应减少焊膏中助焊剂的比例。


