BGA焊接的方法技巧【图文】
在SMT贴片加工中,常常需要对BGA进行返修,而,BGA元器件的的返修不是一件简单的事,所以对BGA焊接掌握一定的方法技巧是非常有必要的。
对BGA进行焊接和拆卸,最好使用专门的BGA返修台,没有条件的话,也可以用热风枪、电烙铁等工具对BGA进行焊接,焊接的效率没这么好。接下来对两种不同的方法进行介绍。
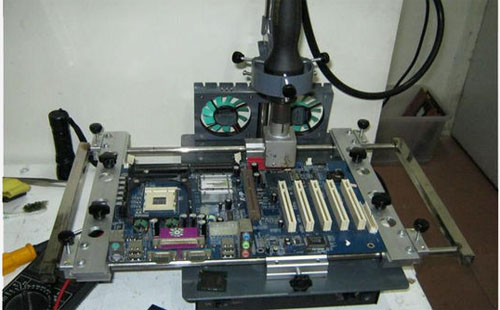
一、BGA返修台的焊接
1、调整位置
BGA在进行芯片焊接时,要调整好位置,确保芯片处于上下出风口之间,将PCB用夹具向两端扯紧,固定好!以用手触碰主板主板不晃动为标准。
2、调整预热温度。
在进行BGA焊接前,主板要首先进行充分分的预热,这样可有效保证主板在加热过程中不形变且能够为后期的加热提供温度补偿。
关于预热温度,这个应该根据室温以及PCB厚薄情况进行灵活调整,比如在冬季室温较低时可适当提高预热温度,而在夏季则应相应的降低一下。若PCB比较薄,也需要适当提高一点预热温度!具体温度因BGA返修台而定。
3、调整好焊接曲线。
调整大致方法:找一块PCB平整无形变的主板,用焊台自带曲线进行焊接,在第四段曲线完成时将焊台所自带的测温线,插入芯片和PCB之间,获得此时的温度。理想值无铅可以达到217度左右,有铅可以达到183度左右。这两个温度即是上述两种锡球的理论熔点!但此时芯片下部锡球并未完全熔化,我们从维修的角讲理想温度是无铅235度左右,有铅200度左右。此时芯片锡球熔化后再冷却会达到最理想的强度
4、适量的使用助焊剂!
无论是重新焊接还是直接补焊,我们都需要先涂上助焊剂。芯片焊接时可用小毛刷在清理干净的焊盘上薄薄的涂上一层,尽量抹均匀,千万不要刷的太多,否则也会影响焊接。在补焊时可用毛刷蘸取少量助焊剂涂抹在芯片四周即可。助焊剂请选用BGA焊接专用的助焊剂!
5、BGA焊接时对位一定要精确。
由于大家的返修台都配有红外扫描成像来辅助对位,这一点应该没什么问题。如果没有红外辅助的话,我们也可以参照芯片四周的方框线来进行对位。注意尽量把芯片放置在方框线的中央,稍微的偏移也没太大问题,因为锡球在熔化时会有一个自动回位的过程,轻微的位置偏移会自动回正!
6、在焊接过程中,我们不可避免的要接触到植锡球这个工作。一般来说植球需要如下工具:
(1)锡球。目前我们常用的锡球直径一般有0.25MM,0.45MM,0.6MM三种。其中0.6MM规格的锡球目前仅发现用在MS99机芯的主芯片上,0.25MM规格的锡球仅为EMMC程序IC上使用的。其余无论DDR还是主芯片均使用0.45MM规格的(当然使用0.4MM也是可以的)。同时建议使用有铅锡球,这样比较容易焊接。(2)钢网。由于我们使用芯片的通用性限制,除DDR钢网外,市面上很少有和我们芯片完全一致的配套钢网,所以我们只能采用通用钢网。
一般我们采用0.5MM孔径,球距0.8MM的钢网和孔径0.6MM,球距离0.8MM的钢网。
(3)植球台。植球台的种类有很多,我建议大家使用直接加热的简易植球台。这种植球台价格便宜,且容易操作。
7、植锡球的操作方法:
(1)将拆下来的芯片焊盘用吸锡线配合松香处理平整,并用洗板水刷干净后用风枪吹干。
(2)将芯片上均匀涂上一层助焊剂,不要涂得过多,薄薄的一层即可。
(3)将芯片置于钢网下并将其安放到植球台上,然后一定要仔细调整钢网孔和芯片焊盘的安放位置,确保精确对应。
(4)对准位置后,将锡球撒入少许到刚网上。
(5)用软排线将锡球缓缓刮入到钢网孔内焊盘上。如果刮完后发现仍有少量焊盘内无锡球,可以再次倒入少许锡球继续刮,或是用镊子将锡球逐个填入。
(6)上述步骤准备就绪后,将风枪前的聚风口拆除并将风枪温度跳到360—370度之间,且将风速调至很小,略微出风就可以。因为温度过高或是风速过大易引起钢网变形,导致植球失败。调整好后就可以对锡球进行均匀加热了。加热时要注意锡球颜色变化,当锡球加热到明显发亮,且锡球明显排列有序的时候,就可以停止了,整个过程大约耗时20-30秒。
(7)冷却后将钢网取下,此时我们会发现锡球已经基本上植完了,剩下的工作就是用洗板水对芯片焊盘进行清洗,将一些空位上的锡球清除掉,同时看看是否有个别焊盘未植上,或是没有植好。如有此类情况可在该处焊盘上涂抹少许助焊剂并用镊子夹锡球放好,用风枪小风吹化即可。
二、使用热风枪和电烙铁等工具进行的焊接
1、所需工具:
(1)热风枪:用于拆卸和焊接BGA芯片。最好使用有数控恒温功能的热风枪,容易掌握温度,去掉风嘴直接吹焊。
(2)电烙铁:用以清理BGA芯片及线路板上的余锡。
(3)手指钳:焊接时便于将BGA芯片固定。
(4)医用针头:拆卸时用于将BGA芯片掀起。
(5)带灯放大镜:便于观察BGA芯片的位置。
(6)焊锡:焊接时用以补
(7)植锡板:用于BGA芯片置锡。
(8)锡浆:用于置锡。
(9)刮浆工具:用于刮除锡浆。一般的植锡套装工具都配有钢片刮刀或胶条。
(10)手机维修平台:用以固定线路板。维修平台应可靠接地。
(11)防静电手腕:戴在手上,用以防止人身上的静电损坏手机元件器。
(12)小刷子、吹气球:用以扫除BGA芯片周围的杂质
(13)助焊剂:选用专门的BGA助焊剂
2、具体操作方法
(1)认清BGA芯片放置之后应在芯片上面放适量助焊剂,既可防止干吹,又可帮助芯片底下的焊点均匀熔化,不会伤害旁边的元器件。 去掉热风枪前面的套头用大头,将热量开关一般调至3-4档,风速开关调至2-3档,在芯片上方约2.5cm处作螺旋状吹,直到芯片底下的锡珠完全熔解,用镊子轻轻托起整个芯片。
(2)BGA芯片取下后,芯片的焊盘上和手机板上都有余锡,此时,在线路板上加上足量的助焊膏,用电烙铁将板上多余的焊锡去除,并且可适当上锡使线路板的每个焊脚都光滑圆润.吸锡的时候应特别小心,否则会刮掉焊盘上面的绿漆和焊盘脱落。做好准备工作。对于拆下的IC,建议不要将IC表面上的焊锡清除,只要不是过大,且不影响与植锡钢板配合即可,如果某处焊锡较大,可在BGAIC表面加上适量的助焊膏,用电烙铁将IC上的过大焊锡去除,然后用天那水洗净。
(3)BGA-IC的固定。将IC对准植锡板的孔后(注意,如果使用的是那种一边孔大一边孔小的植锡板,大孔一边应该与IC紧贴),用标签贴纸将IC与植锡板贴牢,IC对准后,把植锡板用手或镊子按牢不动,然后另一只手刮浆上锡浆。如果锡浆太稀,吹焊时就容易沸腾导致成球困难,因此锡浆越干越好,只要不是干得发硬成块即可。如果太稀,可用餐巾纸压一压吸干一点。平时可挑一些锡浆放在锡浆瓶的内盖上,让它自然晾干一点。用平口刀挑适量锡浆到植锡板上,用力往下刮,边刮边压,使锡浆均匀地填充于植锡板的小孔中。
(4)吹焊成球。将热风枪的风嘴去掉,将风量调至最小,将温度调至330--340度,也就是3-4档位。晃风嘴对着植锡板缓缓均匀加热,使锡浆慢慢熔化。当看见植锡板的个别小孔中已有锡球生成时,说明温度已经到位,这时应当抬高热风枪的风嘴,避免温度继续上升。过高的温度会使锡浆剧烈沸腾,造成植锡失败;严重的还会使IC过热损坏。
(5)如果吹焊成球后,发现有些锡球大小不均匀,甚至有个别脚没植上锡,可先用裁纸刀沿着植锡板的表面将过大锡球的露出部分削平,再用刮刀将锡球过小和缺脚的小孔中上满锡浆,然后用热风枪再吹一次即可。如果锡球大小还不均匀的话,可重复上述操作直至理想状态。
(6)再将植好锡球的BGA-IC按拆卸前的定位位置放到线路板上,同时,用手或镊子将IC前后左右移动并轻轻加压,这时可以感觉到两边焊脚的接触情况。因为两边的焊脚都是圆的,所以来回移动时如果对准了,IC有一种“爬到了坡顶”的感觉,对准后,因为事先在IC的脚上涂了一点助焊膏,有一定粘性,IC不会移动。如果IC对偏了,要重新定位。BGA-IC定好位后,就可以焊接了。
(7)和植锡球时一样,把热风枪的风嘴去掉,调节至合适的风量和温度,让风嘴的中央对准IC的中央位置,缓慢加热。当看到IC往下一沉且四周有助焊膏溢出时,说明锡球已和线路板上的焊点熔合在一起。这时可以轻轻晃动热风枪使加热均匀充分,由于表面张力的作用,BGA-IC与线路板的焊点之间会自动对准定位,注意在加热过程中切勿用力按住BGA-IC,否则会使焊锡外溢,极易造成脱脚和短路。焊接完成后用天那水将板洗干净即可。
(8)为了防止焊上BGA-IC时线路板原起泡处又受高温隆起,我们可以在安装IC时,在线路板的反面垫上一块吸足水的海绵,这样就可避免线路板温度过高。
BGA的体积越来越小,维修的难度也将会增加,在BGA焊接时,需要不断的实践操作改进,采用合适的焊接方法,就可以增加焊接的成功率了。


